FIB-SEM с плазменной пушкой в качестве источника ионов Xe+ и неиммерсионной электронной колонной с ультравысоким разрешением
TESCAN AMBER X – аналитический двулучевой сканирующий электронно-ионный микроскоп с плазменной пушкой в качестве источника ионов и неиммерсионной электронной колонной с ультравысоким разрешением, разработанный для исследований образцов, при работе с которыми возникают затруднения у традиционных FIB-SEM с жидкометаллическим источником ионов Ga+ и SEM с катодом Шоттки.
TESCAN AMBER X сочетает в себе ионную колонну (FIB) с плазменной ионной пушкой и электронную колонну BrightBeam™, что позволяет с высокой эффективностью создавать поперечные сечения большой площади и получать изображения с ультравысоким разрешением в неиммерсионном режиме при проведении двух- и трехмерных мультимодальных исследований широкого спектра традиционных и новых материалов. С помощью микроскопа TESCAN AMBER X ваша лаборатория сможет соответствовать запросам на исследования материалов, которые у вас есть на сегодняшний день, а также вы будете подготовленными к анализу материалов будущего.
TESCAN AMBER X с плазменной ионной пушкой позволяет быстро создавать поперечные сечения большой площади (вплоть до ширины 1 мм), а также изготавливать поперечные сечения обычных (небольших) размеров и проводить их полировку. Инертная природа ионов ксенона Xe+ позволяет без артефактов подготовить ионным пучком к исследованию такие материалы, как, например, алюминий, без риска, что микроструктурные или механические свойства этих материалов под воздействием пучка ионов будут видоизменены. Ионы Xe+ создают минимальные повреждения образца и имеют значительно меньшую степень имплантации по сравнению с ионами Ga+, которые используются в традиционных FIB с жидкометаллическим источником ионов галлия в качестве ионной пушки.
Работа внутрилинзовых детекторов вторичных и обратно отражённых электронов оптимизирована для получения высококачественных изображений в точке пересечения ионного и электронного пучков. Запатентованная геометрия камеры TESCAN AMBER X обладает значительным аналитическим потенциалом с точки зрения размещения в камере микроскопа детекторов для микроанализа, которые позволяют проводить не только микроанализ поверхности образцов, но также и мультимодальную 3D-томографию.
Благодаря настраиваемому модульному программному обеспечению TESCAN Essence™, через которое осуществляется управление микроскопом, TESCAN AMBER X легко превращается из многопользовательской и многоцелевой системы в специальный инструмент для выполнения FIB-операций с высокой эффективностью.
Модели микроскопов TESCAN AMBER X называются AMBER X GMH или AMBER X GMU в зависимости от наличия режима низкого вакуума (подробнее во вкладке «Характеристики»).
Ключевые преимущества- Высокая производительность, создание поперечных сечений большой площади (шириной вплоть до 1 мм)
- Подготовка образцов на микроуровне без имплантирования в материал образца ионов Ga+
- Получение изображений с ультравысоким разрешением без использования магнитного поля вокруг образца, проведение микроанализа
- Внутрилинзовые детекторы вторичных и обратно отражённых электронов
- Оптимизация токов электронного и ионного пучков для проведения высокопроизводительной мультимодальной FIB-SEM томографии
- Расширенное поле обзора и удобная навигация по образцу
- Простой в использовании модульный графический интерфейс пользователя Essence™
SEM – от англ. scanning electron microscope, сканирующий электронный микроскоп
BDT – от англ. beam deceleration technology, технология торможения пучка
ПО TESCAN Essence™
- Настраиваемый графический интерфейс
- Многопользовательский интерфейс с учетными записями с настраиваемым уровнем доступа
- Панель быстрого поиска окон интерфейса
- Отменить последнюю команду / Вернуть последнюю команду
- Отображение одного, двух, четырех или шести изображений одновременно в реальном времени
- Многоканальное цветное живое изображение
- Контроль эмиссии электронного и ионного пучков
- Центрирование электронной пушки
- Авто контраст/яркость, автофокус
- In-Flight Beam Tracing™ (технология контроля и оптимизации рабочих характеристик и параметров пучка в реальном времени)
- Оптимизация тока электронного пучка для выбранного диаметра электронного пучка, и наоборот
- Оптимизация распределения тока вдоль профиля ионного пучка
- Автоматическая процедура совмещения пучков FIB и SEM
- Позиционирование и контроль температуры форсунки GIS
- Измерения (расстояния; периметры и площади кругов, эллипсов, квадратов и полей неправильной формы, калибровка размера точки, экспорт измерений для статистической обработки и другие функции), контроль допусков
- Обработка изображений (коррекция яркости/контраста, улучшение резкости, подавление шумов, сглаживание и увеличение четкости, дифференциальный контраст, коррекция тени, адаптивные фильтры, быстрое Фурье-преобразование и др. функции)
- Предустановки
- Гистограмма и шкала оттенков (LUT)
- SharkSEM™ Basic (удаленный контроль)
- 3D-модель схемы коллизий
- Площадь объекта (выделение на снимке объектов с близким уровнем серого и измерение площади, занимаемой этими объектами)
- Позиционер (навигация по образцу в соответствии с шаблоном, в качестве которого может выступать СЭМ-изображение, изображение с оптического микроскопа, фотография образца)
- Draw BeamTM Live/Expert (программный модуль для создания векторных шаблонов для литографии ионным пучком)
- Таймер выключения
- FIB-SEM томография *
- FIB-SEM томография (расширенная версия) *
- CORAL™ (корреляционная микроскопия для удобной навигации и совмещения СЭМ-снимков со снимками сторонних устройств, например, с оптических микроскопов) *
- Draw Beam Automate (программный модуль для создания векторных шаблонов для литографии ионным пучком с расширенными возможностями автоматизации) *
- Сшивка изображений (автоматический процесс накопления изображений и их сшивки) *
- Sample Observer (обозреватель образца для создания видеоряда из серии СЭМ-снимков, автоматически накопленных через заданный промежуток времени) *
- SharkSEM™ Advanced (создание пользовательских алгоритмов, библиотека скриптов Python) *
- Расширенная самодиагностика *
- Программа-клиент Synopsys (расширение модуля Позиционер, которое совмещает данные макета из внешнего ПО Avalon MaskView c изображениями СЭМ или FIB через удаленное соединение; в основном предназначено для анализа неисправностей полупроводниковых устройств) *
- TESCAN Flow™ (обработка данных в режиме offline) *
- Источник электронов: катод Шоттки
- Объективная линза, сочетающая в себе магнитную и электростатическую линзы
- Потенциальная трубка внутри электронной колонны
- Одновременная регистрация вторичных и обратно отражённых электронов с помощью встроенных в колонну соответствующих детекторов
- Диапазон энергий электронного пучка, падающего на образец: 50 эВ – 30 кэВ (< 50 эВ с технологией торможения пучка BDT, Beam Deceleration Technology) *
- Для изменения тока пучка в качестве устройства смены апертур используется электромагнитная линза
- Ток пучка электронов: 2 пА – 400 нА с непрерывной регулировкой
- Максимальное поле обзора: 7 мм при WD = 6 мм, более 50 мм при макс. WD
- Источник ионов: плазменная пушка, генерирующая ионы ксенона Xe+ (тип пушки ECR), время жизни источника не ограничено
- 30 пьезо-моторизованных апертур
- Электростатический прерыватель пучка со встроенным цилиндром Фарадея
- Диапазон энергий ионного пучка: 3 кэВ – 30 кэВ
- Ток пучка ионов: 1 пА –3 мкА
- Максимальное поле обзора: 1 мм
- Точка пересечения пучков FIB и SEM на WD = 6 мм
- Угол наклона столика образцов 55° в точке пересечения пучков FIB и SEM
- 1,5 нм при 1 кэВ (неиммерсионная оптика)
- 1,3 нм при 1 кэВ (c опцией торможения пучка BDT) *
- 0,9 нм при 15 кэВ (неиммерсионная оптика)
- 0,8 нм при 30 кэВ STEM * (неиммерсионная оптика)
- 12 нм при 30 кэВ
- Диапазон перемещения столика по осям X и Y: 130 мм
- Диапазон перемещения столика по оси Z: 90 мм
- Диапазон компуцентрического наклона: от – 60° до + 90°
- Компуцентрическое вращение: 360° непрерывно
- Максимальная высота образца: 90 мм (132 мм без платформы вращения)
- Столик образцов с расширенным диапазоном перемещений *
Вакуумная камера (* – опционально)
- Внутренняя ширина: 340 мм
- Внутренняя глубина: 315 мм
- Количество портов 20+ (количество портов может быть изменено под задачи заказчика)
- Тип подвески: активная электромагнитная
- Увеличение внутреннего объема камеры для 6” и 8” пластин *
- Увеличение внутреннего объема камеры для 6”, 8” и 12” пластин (со столиком образцов с расширенным диапазоном перемещений) *
- Увеличение внутреннего объема камеры для размещения дополнительного рамановского микроскопа со спектрометром (RISE™) *
- Инфракрасная камера обзора
- Вторая инфракрасная камера обзора *
- Интегрированная плазменная очистка камеры образцов (деконтаминатор)
- Режим высокого вакуума HighVac™: < 9∙10-3 Па (AMBER X GMH работает только в режиме HighVac™)
- Режим низкого вакуума UniVac™: 7 – 500 Па * (присутствует в AMBER X GMU)
- Типы насосов: все насосы безмасляные
- Шлюз *
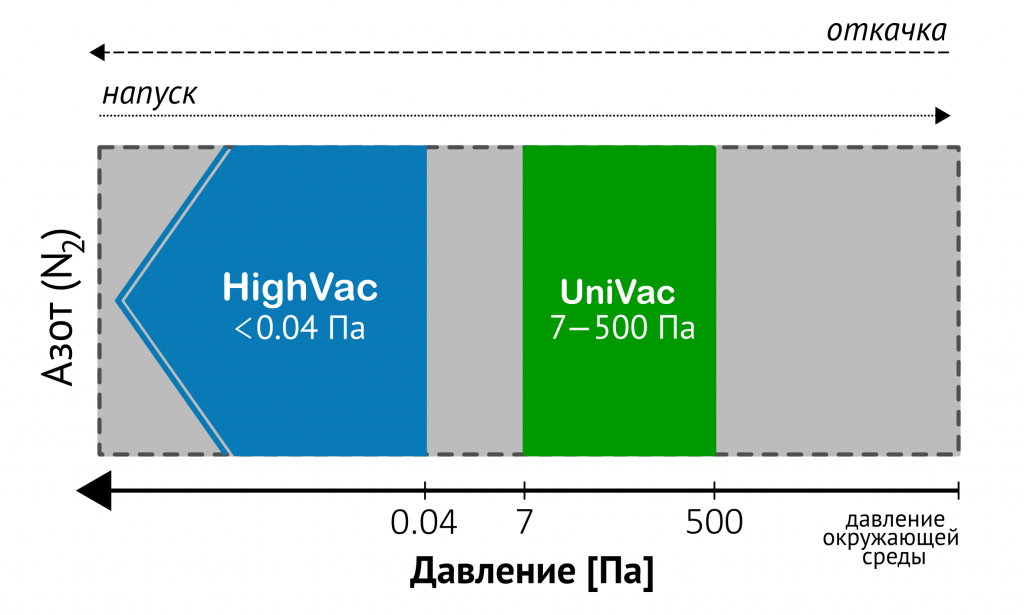
- Измеритель поглощенного тока, включающий в себя функцию датчика касания
- Внутрикамерный детектор вторичных электронов типа Эверхарта-Торнли (SE)
- Встроенный в электронную колонну детектор вторичных электронов (MD)
- Встроенный в электронную колонну приосевой детектор вторичных/отраженных электронов (Axial)
- Сцинтилляционный детектор вторичных электронов для работы в режиме низкого вакуума (LVSTD) *
- Детектор вторичных ионов (SITD) *
- Выдвижной детектор отраженных электронов сцинтилляционного типа, чувствительный в том числе в области низких энергий первичного пучка (LE-BSE) *
- Выдвижной детектор отражённых электронов сцинтилляционного типа (R-BSE) *
- 4-сегментный выдвижной полупроводниковый детектор отражённых электронов, чувствительный в том числе в области низких энергий первичного пучка (LE 4Q BSE) *
- Выдвижной детектор отраженных электронов сцинтилляционного типа с водяным охлаждением, устойчив к высоким температурам <800°C *
- Выдвижной детектор отраженных электронов сцинтилляционного типа с Al-покрытием для одновременного детектирования BSE- и катодолюминесцентного излучения *
- Выдвижной панхроматический детектор катодолюминесцентного излучения со спектральным диапазоном 350 – 650 нм *
- Выдвижной панхроматический детектор катодолюминесцентного излучения со спектральным диапазоном 185 – 850 нм *
- Выдвижной 4-х канальный детектор цветной катодолюминесценции Rainbow CL *
- Выдвижной детектор прошедших электронов (R-STEM), изображения светлого поля (BF), тёмного поля (DF) и в рассеянных на большие углы электронах (HADF), держатель для 8 сеточек *
- EDS – энергодисперсионный спектрометр (интегрированный продукт другого производителя), при приобретении EDS требуется шаттер для защиты EDS в течение FIB-процессов *
- EBSD – анализ картин дифракции отражённых электронов (интегрированный продукт другого производителя) *
- WDS – волнодисперсионный спектрометр (интегрированный продукт другого производителя) *
- Интегрированный с FIB вторично-ионный масс-спектрометр (TOF-SIMS) *
- Конфокальный рамановский микроскоп со спектрометром (RISE™) *
- Выдвижной OptiGIS™ с одним резервуаром; доступно до 3 OptiGIS™ на одной камере с возможностью выбора прекурсоров *
- 5-GIS *: GIS c 5-ю независимыми резервуарами и капиллярами для 5-ти прекурсоров, но занимающий при этом только один порт камеры микроскопа, моторизация по 3-м осям
- Осаждение платины (Pt) *, рекомендуемая опция
- Осаждение вольфрама (W) *
- Осаждение углерода (С) *
- Осаждение диэлектрика (SiOx) *
- Ускоренное травление (H2O) *
- Ускоренное травление (XeF2) *
- Запатентованные прекурсоры для процесса IC planar delayering (стравливание микросхем слой за слоем в планарной геометрии, а не традиционными поперечными кросс-секциями) *
- Другие прекурсоры по запросу *
- Полностью интегрированный XYZ-наноманипулятор *, рекомендуемая опция
- Опция Rocking Stage (качающийся столик) для создания кросс-секций, на поверхности которых нет артефакта «занавески» *
- Набор кремниевых масок True-X для создания безартефактных поперечных сечений *, рекомендуемая опция
- Наноманипуляторы других производителей по запросу *
- Создание потока медленных электронов для нейтрализации заряда в процессе FIB-травления *
- Пьезо-шаттер для защиты EDS в процессе FIB-травления *
- Время выдержки: 20 нс – 10 мс на пиксель, регулируется ступенчато или непрерывно
- Варианты сканирования: полный кадр, выделенная область, сканирование по линии и в точке
- Сдвиг и вращение области сканирования, коррекция наклона поверхности образца
- Аккумулирование линий или кадров
- DrawBeam™: программный модуль для создания векторных шаблонов для литографии ионным пучком, цифро-аналоговый преобразователь 16-бит
- Максимальный размер кадра: 16k x 16k пикселей
- Соотношение сторон изображения: 1:1, 4:3 и 2:1
- Сшивка изображений, размер панорам не ограничен (требуется программный модуль Image Snapper) *
- Одновременное накопление сигналов с нескольких каналов детектирования (вплоть до 8 каналов)
- Псевдоокрашивание изображений и микширование многоканальных сигналов
- Множество форматов изображений, включая TIFF, PNG, BMP, JPEG и GIF
- Глубина градаций серого (динамический диапазон): 8 или 16 би